全球半导体研发投入Top20:英特尔第一,台积电第七!
9月2日,半导体研究机构TechInsights发布了一份最新的研究报告,披露了2024年全球半导体企业投资排名前20位的厂商名单。
报告显示,深陷“财务危机”的英特尔依旧以165.46亿美元的研发投入占据着第一的位置,紧随其后的前十厂商分别是英伟达、三星电子、博通、高通、AMD、台积电、联发科、美光和SK海力士。而要上Top20榜单,研发投入的门槛则是9.69亿美元。
整体来看,排名前20位的半导体公司的研发支出总额达986.8亿美元,同比增长了17%,约占全球半导体行业研发支出总额的96%。排名前20位的半导体公司平均研发支出占销售额的比重为15.8%。
从研发支出同比变化来看,有15家公司同比增加了研发支出,剩下的5家公司的研发支出则同比下滑。
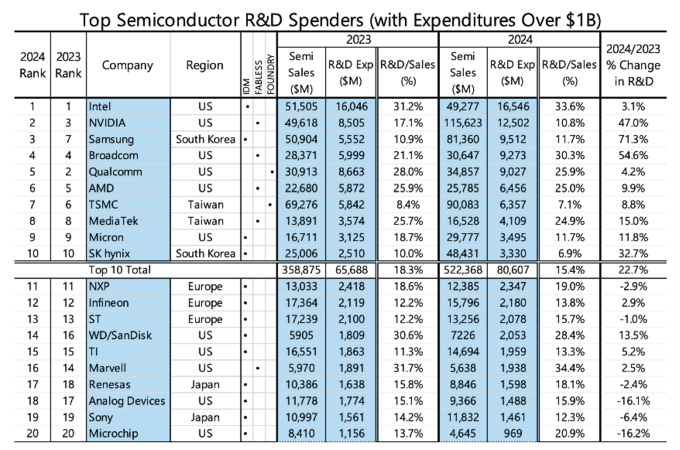
报告指出,英特尔2024年在研发上的投入最多,达到165.46亿美元,主要用于其代工业务,包括18A(1.8纳米)工艺,较前一年增长3.1%。
英伟达位居第二,研发投入达125亿美元,同比增长47%。
三星电子则将研发投入从上一年的55亿美元大幅提升至95亿美元,排名从第七跃升至第三。然而,三星电子的年增长率最高(71.3%)。TechInsights评估道:“三星电子在尖端工艺节点领域与台积电、英特尔和Rapidus等领先公司展开竞争,同时在DRAM和NAND闪存市场也与其他厂商展开激烈竞争,而这两个市场在过去三年中一直面临困境。”
在研发投入占销售额比例方面,英特尔以33.6%高居榜首,其次是博通(30.3%)、高通(25.9%)和AMD(25.0%),美国半导体公司占据前列。二十大公司的平均研发支出占销售额比例为15.8%,而三星电子和SK海力士分别为11.7%和6.99%,低于整体平均水平。值得一提的是,尽管SK海力士的研发投入较前一年增加了32%以上,但由于其销售额几乎翻倍,研发占比反而下降。
TechInsights预测,英伟达有望在明年成为研发投入最多的公司。
需要指出的是,台积电是研发投入超过10亿美元的公司中唯一一家纯晶圆代工厂。台积电于2010年首次进入研发投入前十名(排名第10)。2010年的研发支出为9.43亿美元,到2024年增长574%,达到63.57亿美元,这是台积电13年来首次达到这一水平。
在2024年研发支出排名前十的公司中,有6家总部位于美国,2家位于中国台湾,2家位于韩国。前十家公司中有5家是无晶圆厂半导体公司,分别是高通、英伟达、AMD、博通和联发科。4家是IDM公司(英特尔、三星电子、美光和恩智浦)。
在研发支出排名前11至20的公司中,有5家总部位于美国,3家位于欧洲,2家位于日本。其中,IDM公司占9家,无晶圆厂半导体公司仅1家。
在线留言询价

全球半导体营收,将达1万亿美元!

从设计到封测:一文读懂半导体产业核心术语
- 一周热料
- 紧缺物料秒杀
| 型号 | 品牌 | 询价 |
|---|---|---|
| BD71847AMWV-E2 | ROHM Semiconductor | |
| MC33074DR2G | onsemi | |
| RB751G-40T2R | ROHM Semiconductor | |
| TL431ACLPR | Texas Instruments | |
| CDZVT2R20B | ROHM Semiconductor |
| 型号 | 品牌 | 抢购 |
|---|---|---|
| ESR03EZPJ151 | ROHM Semiconductor | |
| IPZ40N04S5L4R8ATMA1 | Infineon Technologies | |
| BU33JA2MNVX-CTL | ROHM Semiconductor | |
| BP3621 | ROHM Semiconductor | |
| TPS63050YFFR | Texas Instruments | |
| STM32F429IGT6 | STMicroelectronics |
AMEYA360公众号二维码
识别二维码,即可关注


请输入下方图片中的验证码:
























