- Ameya360 Component Supply Platform >
- Trade news >
- 一文了解芯片BGA封装的工艺流程
一文了解芯片BGA封装的工艺流程
球栅阵列(简称BGA)封装作为现代电子封装的重要形式,因其优异的性能和高密度的引脚排列被广泛应用于微处理器、存储器及各类集成电路中。
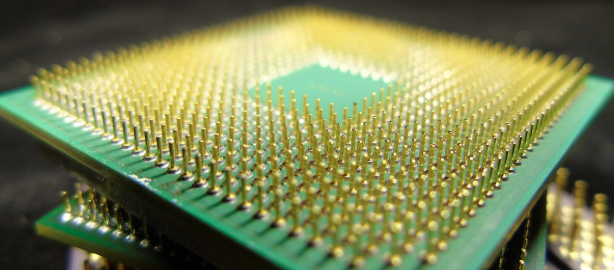
BGA封装简介
BGA封装通过在芯片下方布置均匀分布的焊球,实现与外部电路板的连接。相比传统的引线封装,BGA封装具有引脚密度更高、热性能更好和电性能优越等优点。
BGA封装的工艺流程
1.芯片准备
首先选用经过测试合格的集成电路芯片(Die),对其进行清洗和表面处理,确保芯片表面无杂质,为后续封装做好准备。
2.芯片键合(芯片引线连接)
根据具体封装结构,采用焊线键合(WireBonding)或倒装芯片(FlipChip)技术将芯片与基板上的电极相连。
焊线键合:通过细金属线将芯片引脚与封装基板进行连接。
倒装芯片:芯片倒装,通过微凸点直接与基板焊盘连接,提高电性能。
3.封装基板装配
将芯片键合后的基板进行安装,进行封装材料的涂覆。常见封装材料为环氧树脂,这一步骤称为模塑封装(Molding),起到保护芯片和键合线、防止物理和化学损伤的作用。
4.焊球的形成
在封装完成后,通过掩膜印刷锡膏或直接点焊球工艺在封装基板的焊盘上形成一定规格的锡球。锡球需均匀分布并尺寸一致,这是BGA接合质量的关键因素。
5.焊球回流焊
锡球经过加热熔化后重新结晶,形成牢固的焊点。这一过程称为回流焊(ReflowSoldering),需严格控制温度曲线以保证焊球的完整性和焊点的可靠性。
6.检测与测试
完成封装后的BGA产品需要进行多项质量检测:
视觉检测:检查焊球形状、尺寸及分布是否均匀。
X射线检测:检查焊点内部缺陷,如空洞、裂纹等。
功能测试:确认芯片封装后的电气性能正常。
7.切割和分离
将大批量封装基板切割成单个或多单元封装芯片,完成封装产品的最终成型。
BGA封装工艺包含芯片准备、键合、模塑、焊球形成及回流焊等多道工序。每一步都对最终产品的性能和可靠性有重要影响。
Previous:江西萨瑞微电子防雷模组:为严苛环境打造36V/30KA高可靠守护者!
Online messageinquiry
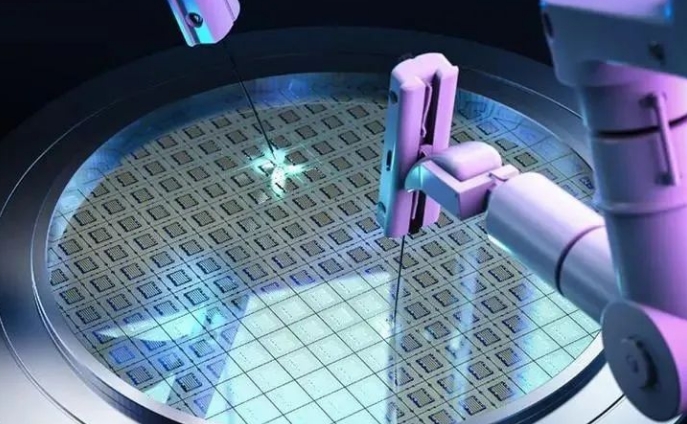
掩膜版在先进封装中的应用

引线框架对半导体器件性能与可靠性的影响
- Week of hot material
- Material in short supply seckilling
| model | brand | Quote |
|---|---|---|
| MC33074DR2G | onsemi | |
| CDZVT2R20B | ROHM Semiconductor | |
| BD71847AMWV-E2 | ROHM Semiconductor | |
| TL431ACLPR | Texas Instruments | |
| RB751G-40T2R | ROHM Semiconductor |
| model | brand | To snap up |
|---|---|---|
| BP3621 | ROHM Semiconductor | |
| BU33JA2MNVX-CTL | ROHM Semiconductor | |
| TPS63050YFFR | Texas Instruments | |
| STM32F429IGT6 | STMicroelectronics | |
| ESR03EZPJ151 | ROHM Semiconductor | |
| IPZ40N04S5L4R8ATMA1 | Infineon Technologies |
Qr code of ameya360 official account
Identify TWO-DIMENSIONAL code, you can pay attention to


Please enter the verification code in the image below:






















