掩膜版在先进封装中的应用
掩膜版(Photomask/Reticle)在半导体先进封装中扮演着至关重要的角色,其核心功能与在晶圆制造前端(FEOL)类似:精确地定义光刻胶上的图形,从而在基板或晶圆上形成所需的金属布线、通孔、凸点等结构。 随着先进封装技术向更高密度、更小尺寸、更复杂互连发展,掩膜版的应用变得更加精细和关键。
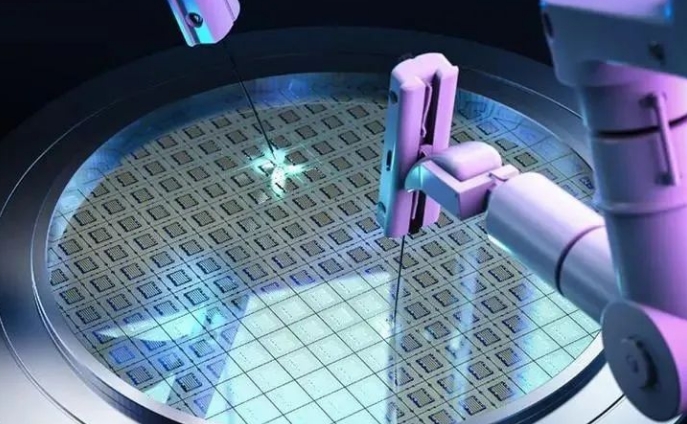
以下是掩膜版在先进封装中的主要应用领域和技术要点:
1.再分布层:
应用: 这是掩膜版在先进封装中最核心的应用之一。RDL 是在芯片表面或封装基板上制作额外的金属布线层,将芯片的 I/O 焊盘重新布局到更利于封装互连的位置(例如,从芯片边缘分布到整个表面)。
掩膜版作用: 通过光刻工艺,掩膜版定义了 RDL 中金属导线(Trace)、连接盘(Pad)以及金属层间连接的通孔(Via)的精确图形。这通常需要多块掩膜版(一层金属对应一块掩膜版,一层通孔对应一块掩膜版)。
先进封装要求: 随着扇出型封装(Fan-Out)、2.5D/3D IC 的发展,RDL 的线宽/间距(L/S)要求越来越小(从几微米向亚微米发展),对掩膜版的精度(CD 均匀性、套刻精度)、缺陷控制要求极高。需要更高分辨率的光刻技术(如步进式光刻机)和更精密的掩膜版。
2.凸点下金属化层:
应用: UBM 是在芯片焊盘或 RDL 焊盘上制作的一层金属结构,用于确保焊料凸点(Solder Bump)或铜柱凸点(Cu Pillar)的良好粘附、扩散阻挡和润湿。
掩膜版作用: 掩膜版用于定义 UBM 层的图形(通常是一个个圆形或方形开口),限制电镀或沉积区域,确保 UBM 仅在焊盘位置精确形成。UBM 的尺寸和位置精度对凸点的形成质量和可靠性至关重要。
3.硅通孔:
应用: TSV 是实现 2.5D/3D 堆叠封装(如 HBM 与逻辑芯片集成)的关键技术,在硅中介层或芯片内部垂直穿孔并填充金属,实现芯片间的垂直互连。
掩膜版作用:
深孔刻蚀掩膜: 在硅上刻蚀深孔(通常深宽比很高)之前,需要在硅表面定义刻蚀区域。掩膜版(通常是厚胶或硬掩膜上的图形)用于保护非刻蚀区域。
金属填充图形化: 在 TSV 内填充导电材料(如铜)后,需要去除表面的多余金属(过电镀)。掩膜版用于定义需要保留的金属图形(例如,连接到 RDL 的 Pad),保护区域外的金属被蚀刻掉。这对套刻精度要求很高。
4.封装基板制造:
应用: 虽然传统基板(如有机基板)可能使用激光直写或印刷技术,但高密度互连(HDI)基板,尤其是用于先进封装的芯材(Coreless/SLT)或类载板(SLP),越来越多地采用类似半导体的光刻工艺。
掩膜版作用:掩膜版用于在基板铜箔上光刻出精细的线路、焊盘和通孔图形,然后通过蚀刻或加成法形成电路。先进封装要求基板具有更细的线宽/间距(几十微米到几微米),掩膜版是实现这一目标的关键。
5.扇出型封装:
应用:Fan-Out WLP/PLP 将芯片嵌入模塑料中,然后在重构的“晶圆”上制作 RDL。
掩膜版作用:掩膜版在此主要应用于 RDL 的制作(如第1点所述)。但由于基板是模塑料,其平整度、热膨胀系数与硅片不同,对光刻工艺(包括掩膜版的套刻)提出了额外的挑战。
6.微凸点/铜柱形成:
应用:用于芯片间或芯片与基板间直接互连的微小焊料凸点或铜柱。
掩膜版作用:类似于 UBM,掩膜版(通常是厚的光刻胶)用于定义电镀开口区域,精确控制每个凸点的位置、尺寸和形状。微凸点的间距(Pitch)越来越小(从 100+μm 向 40μm 甚至更低发展),要求掩膜版开口极其精确且边缘陡直。
7.临时键合/解键合层图形化:
应用:在薄晶圆处理或 3D 堆叠工艺中,需要将承载晶圆与器件晶圆临时键合,处理完成后再解键合。
掩膜版作用:可能需要掩膜版来图形化临时键合胶或解键合层,例如在特定区域制作排气通道或控制粘附力区域。
先进封装对掩膜版的关键要求与挑战:
01高精度:
线宽/间距(L/S)缩小,要求掩膜版具有优异的临界尺寸(CD)均匀性、低线宽粗糙度(LWR/LER)和高套刻精度(Overlay)。
02大尺寸:
先进封装常处理更大尺寸的晶圆(如 300mm)或面板级封装(Panel Level Packaging, PLP)的面板(如 500x500mm² 或更大)。大尺寸掩膜版的制作、检测、处理和稳定性是巨大挑战。
03非理想基底:
封装基板(有机材料、模塑料等)相比硅片具有更差的平整度、更高的热膨胀系数和不同的表面特性,增加了光刻和套刻难度,对掩膜版的工艺窗口要求更宽。
04缺陷控制:
掩膜版上的任何缺陷都可能转移到产品上,导致短路、开路或可靠性问题。先进封装对掩膜版的缺陷密度要求非常严格。
05成本压力:
虽然单块掩膜版成本可能低于前端最先进节点,但封装光刻层数可能较多,且大尺寸掩膜版本身成本高昂。如何在满足性能要求下控制成本是关键。
06特殊结构:
可能需要制作非标准图形,如用于 TSV 的深孔阵列或特殊形状的凸点开口。
总结
掩膜版是先进封装技术实现高密度互连、微细化结构和复杂集成架构不可或缺的“模板”。它在 RDL、UBM、TSV、凸点形成、高密度基板制造等核心工艺步骤中起着图形定义的关键作用。随着先进封装持续向更小尺寸、更高性能、更大尺寸(面板级)和更复杂集成(3D/异构集成)发展,对掩膜版的精度、尺寸、稳定性和成本控制提出了越来越高的要求和挑战。掩膜版技术及其相关光刻工艺的进步是推动先进封装发展的核心驱动力之一。
在线留言询价
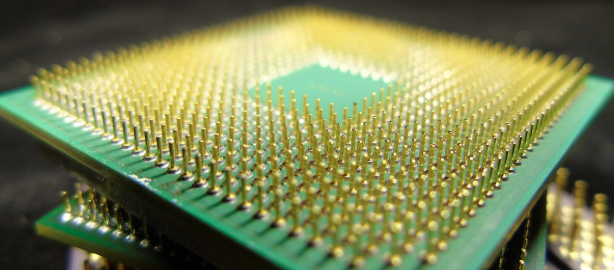
一文了解芯片BGA封装的工艺流程

引线框架对半导体器件性能与可靠性的影响
- 一周热料
- 紧缺物料秒杀
| 型号 | 品牌 | 询价 |
|---|---|---|
| BD71847AMWV-E2 | ROHM Semiconductor | |
| MC33074DR2G | onsemi | |
| CDZVT2R20B | ROHM Semiconductor | |
| TL431ACLPR | Texas Instruments | |
| RB751G-40T2R | ROHM Semiconductor |
| 型号 | 品牌 | 抢购 |
|---|---|---|
| TPS63050YFFR | Texas Instruments | |
| BP3621 | ROHM Semiconductor | |
| ESR03EZPJ151 | ROHM Semiconductor | |
| IPZ40N04S5L4R8ATMA1 | Infineon Technologies | |
| STM32F429IGT6 | STMicroelectronics | |
| BU33JA2MNVX-CTL | ROHM Semiconductor |
AMEYA360公众号二维码
识别二维码,即可关注


请输入下方图片中的验证码:






















