AI需求引爆存储市场,Q4芯片价格飙升近20%!
根据DigiTimes 9月17日发布的数据,2025年第四季度NAND和DRAM的合同价格预计上涨15-20%,淡季价格飙升与人工智能基础设施建设和供应紧张直接相关。
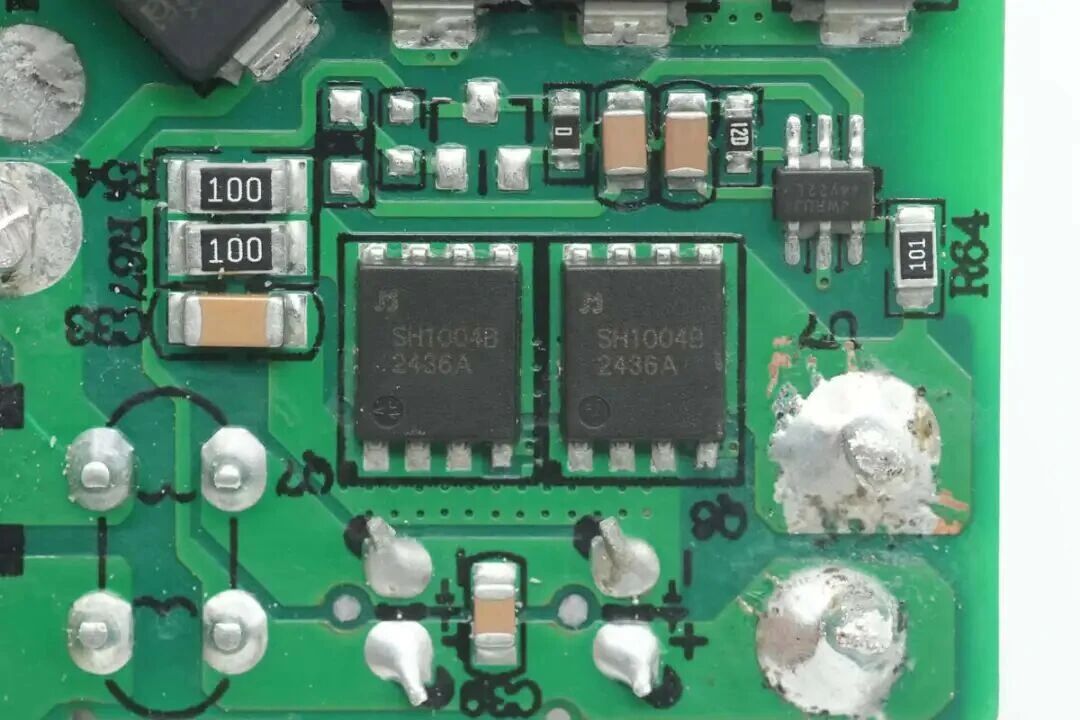
《电子时报》写道:“供应短缺导致云服务提供商积极采购,高堆叠3D NAND产品几乎售罄。”并补充道:“3D NAND……吸引了CSP客户强烈的优先采购兴趣”,理由是他们希望获得更快的读取速度和更大的芯片容量。这与第四季度正常的元件价格通常会走低的模式形成了鲜明对比。
有迹象表明供应端正在收紧。TrendForce表示,SanDisk在9月份推动NAND价格上涨约10%,而美光则在客户预测出现短缺后暂停了DRAM和NAND报价,以重新评估分配情况。该公司还指出,近线HDD存在结构性短缺,这迫使超大规模数据中心运营商加快2026年QLC SSD部署计划。
《电子时报》(DigiTimes)进一步指出,三星2026年的下一代V9 NAND “已接近售罄”,云客户因其更高的密度和成本优势而提前锁定了产能。然而,本周另一份TrendForce简报称,三星已将V9 QLC的上市时间推迟到2026年上半年,这表明客户可能在确定的量产时间之前就预留了产能。无论如何,显而易见的是,云买家正在积极争取未来很长一段时间的供应。
这很容易对消费价格产生连锁反应。如果超大规模厂商正在吸收更多用于企业级SSD的晶圆,而DRAM制造商则优先考虑服务器部件和HBM,那么零售价格将会失去一些弹性。TrendForce已经警告称,随着产能重新分配,传统DRAM类型仍然面临最大的压力,如果云订单继续增加,NVMe硬盘常见的冬季特价可能会比预期的要少。
资金正在易手的一个迹象是控制器专家群联电子8月份创纪录的业绩。该公司公布的营收为59.34亿新台币,同比增长23%。与去年疲软的基数相比,这是一个巨大的增长。群联电子将这一强劲增长归因于非消费类需求以及与NAND制造商更紧密的合作,这符合数据中心主导的闪存供应紧张的大趋势。
归根结底,多个数据点现在汇聚成一个共同的主题:人工智能正在改写云存储体系,而硬盘供应受限,闪存制造商的定价权比往年最后一个季度更强。如果您计划升级,请密切关注零售内存价格,并在出现好价时迅速行动,因为好价位可能不会持续太久。
在线留言询价

一文了解逻辑芯片和处理器芯片的关系

科技部长阴和俊:芯片攻关取得新突破!

一文了解闪存芯片和ROM关系
- 一周热料
- 紧缺物料秒杀
| 型号 | 品牌 | 询价 |
|---|---|---|
| BD71847AMWV-E2 | ROHM Semiconductor | |
| TL431ACLPR | Texas Instruments | |
| MC33074DR2G | onsemi | |
| RB751G-40T2R | ROHM Semiconductor | |
| CDZVT2R20B | ROHM Semiconductor |
| 型号 | 品牌 | 抢购 |
|---|---|---|
| ESR03EZPJ151 | ROHM Semiconductor | |
| STM32F429IGT6 | STMicroelectronics | |
| TPS63050YFFR | Texas Instruments | |
| IPZ40N04S5L4R8ATMA1 | Infineon Technologies | |
| BU33JA2MNVX-CTL | ROHM Semiconductor | |
| BP3621 | ROHM Semiconductor |
AMEYA360公众号二维码
识别二维码,即可关注


请输入下方图片中的验证码:






















