“AI+”推动,我国半导体器件专用设备制造利润大增105.1%!
5月27日,国家统计局发布2025年1—4月份全国规模以上工业企业利润数据。数据显示,1—4月份,全国规上工业企业实现利润总额21170.2亿元,同比增长1.4%。制造业实现利润总额15549.3亿元,增长8.6%。
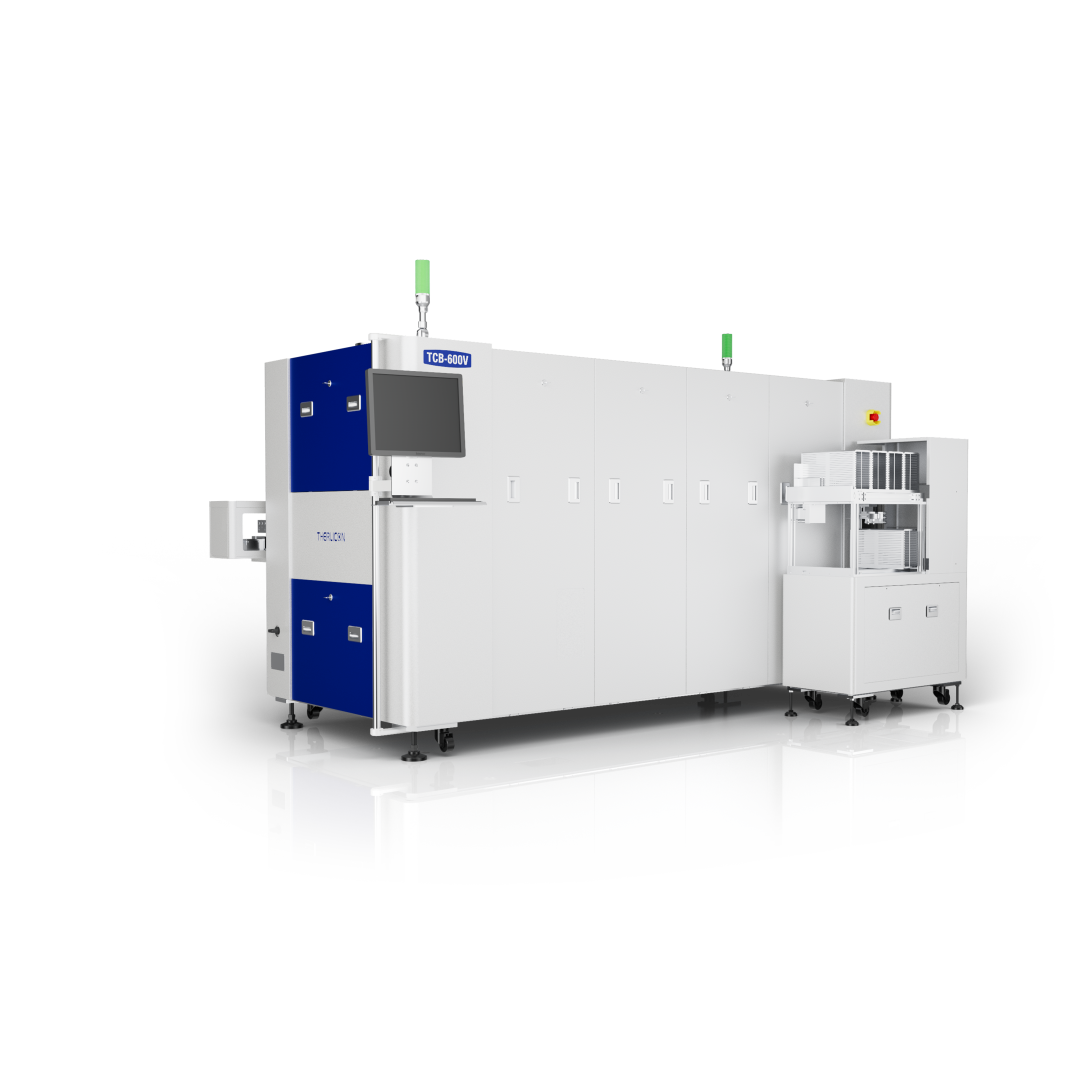
国家统计局工业司统计师于卫宁分析指出,4月份,各地区、各部门加快落实更加积极有为的宏观政策,有力有效应对外部挑战,工业生产实现较快增长,带动规模以上工业企业利润增长加快。特别是以装备制造业、高技术制造业为代表的新动能行业利润增长较快,彰显工业经济发展韧性。
工业企业利润增长加快。1—4月份,规上工业企业利润增长1.4%,较1—3月份加快0.6个百分点,延续恢复向好态势。从行业看,在41个工业大类行业中,有23个行业利润同比增长,增长面近六成。4月份,全国规模以上工业企业利润同比增长3.0%,较3月份加快0.4个百分点。
装备制造业引领作用突出。随着工业产业优化升级深入推进,装备制造业效益持续提升。1—4月份,装备制造业利润同比增长11.2%,较1—3月份加快4.8个百分点;拉动全部规模以上工业利润增长3.6个百分点,拉动作用较1—3月份增强1.6个百分点,对规模以上工业利润增长的引领作用突出。从行业看,装备制造业的8个行业中,有7个行业利润实现两位数增长,6个行业较1—3月份增速加快,其中,仪器仪表、电气机械、通用设备、电子等行业利润分别增长22.0%、15.4%、11.7%、11.6%,较1—3月份加快6.7个、7.9个、2.2个、8.4个百分点。
高技术制造业利润增长加快。1—4月份,高技术制造业利润同比增长9.0%,较1—3月份加快5.5个百分点,增速高于全部规模以上工业平均水平7.6个百分点。从行业看,随着制造业高端化持续推进,生物药品制品制造、飞机制造等行业利润同比增长24.3%、27.0%;“人工智能+”行动深入推进,半导体器件专用设备制造、电子电路制造、集成电路制造等行业利润分别增长105.1%、43.1%、42.2%;智能化产品助力数智化转型,相关的智能车载设备制造、智能无人飞行器制造、可穿戴智能设备制造等行业利润分别增长177.4%、167.9%、80.9%。
“两新”政策效应持续显现。1—4月份,各地区各有关部门用足用好超长期特别国债资金,推动“两新”加力扩围政策继续显效。在大规模设备更新相关政策带动下,专用设备、通用设备行业利润同比分别增长13.2%、11.7%,合计拉动规模以上工业利润增长0.9个百分点。其中,电子和电工机械专用设备制造、通用零部件制造、采矿冶金建筑专用设备制造等行业利润快速增长,增速分别为69.8%、24.7%、18.3%。消费品以旧换新政策加力扩围效果明显,家用电力器具专用配件制造、家用厨房电器具制造、非电力家用器具制造等行业利润分别增长17.2%、17.1%和15.1%。
“总体看,1—4月份规模以上工业企业利润稳定恢复,展现出我国工业强大韧性和抗冲击能力。但也要看到,国际环境变数仍多,需求不足、价格下降等制约因素仍然存在,工业企业效益稳步恢复的基础还需继续巩固。”于卫宁表示,下阶段,要深入贯彻落实党中央、国务院决策部署,推动科技创新和产业创新融合发展,优化调整产业结构,加快传统产业转型升级,培育壮大新兴产业,促进工业企业效益持续恢复向好。
在线留言询价

半导体的基础定义及常见类型有哪些?

高性能芯片的基石:半导体封装技术全解析!

2025年全球半导体TOP10!
- 一周热料
- 紧缺物料秒杀
| 型号 | 品牌 | 询价 |
|---|---|---|
| BD71847AMWV-E2 | ROHM Semiconductor | |
| TL431ACLPR | Texas Instruments | |
| MC33074DR2G | onsemi | |
| RB751G-40T2R | ROHM Semiconductor | |
| CDZVT2R20B | ROHM Semiconductor |
| 型号 | 品牌 | 抢购 |
|---|---|---|
| BP3621 | ROHM Semiconductor | |
| STM32F429IGT6 | STMicroelectronics | |
| IPZ40N04S5L4R8ATMA1 | Infineon Technologies | |
| TPS63050YFFR | Texas Instruments | |
| BU33JA2MNVX-CTL | ROHM Semiconductor | |
| ESR03EZPJ151 | ROHM Semiconductor |
AMEYA360公众号二维码
识别二维码,即可关注


请输入下方图片中的验证码:























