一文了解刻蚀工艺的原理和关键点难点
如果把芯片制造比作一件艺术品的“微雕”,刻蚀就是手握精细刻刀的“雕刻大师”——它将光刻转移的图案精准“雕刻”在硅片上,最终形成沟槽、成千上万以上的晶体管等微观器件结构。没有刻蚀,再简单的电路设计也无法实现,堪称半导体制程的“最重要的一笔”。
刻蚀的核心是通过化学或物理方法,按照预设图案精准去除材料表面不需要的部分,最终在材料上 “雕” 出目标微观结构,这就好比是雕刻大师按设计雕琢精美的作品一样。
只不过雕刻大师的目标是完美的艺术作品,刻蚀的目标则是在微观世界制造产品功能。
一、工艺定位:芯片制造的“关键减法”
在芯片制造全流程中,刻蚀处于光刻之后、薄膜沉积之间,是“图形化工艺”的核心环节。随着制程从14nm迈向3nm、2nm,刻蚀步骤占比大幅提升,单芯片刻蚀次数从数十次增至数百次,其成本占比也攀升至15%-20%,成为仅次于光刻的第二大支出项。
二、核心原理:“遮罩+去除”的精准操作
刻蚀本质是“选择性去除”:先在硅片表面覆盖光刻胶“保护罩”,经光刻曝光后,需要保留的区域被光刻胶覆盖,未被保护的区域则通过化学或物理方法“剥离”,就像用模板遮住蛋糕花纹后,刮掉多余奶油的过程,最终呈现目标电路图案。
三、主流分类:干法与湿法的“各显神通”
1、刻蚀可分为湿法刻蚀和干法刻蚀。
湿法刻蚀各向异性较差,侧壁容易产生横向刻蚀造成刻蚀偏差,通常用于工艺尺寸较大的应用,或用于干法刻蚀后清洗残留物等。干法刻蚀是目前主流的刻蚀技术,占比超90%,其中以等离子体干法刻蚀为主导。
2、湿法刻蚀
用氢氟酸等化学溶液浸泡硅片,溶解未被保护区域。优点是成本低、操作简单;但精度较差,易出现“过刻蚀”,目前多用于28nm以上成熟制程或非关键层加工。
3、干法刻蚀
以等离子体为“刻蚀剂”,通过离子轰击+化学反应双重作用去除材料。优点是精度高(线宽误差可小于1nm)、边缘整齐,是7nm以下先进制程的“主力军”;缺点是设备复杂、成本较高。等离子体刻蚀设备是除光刻机以外最关键的微观加工设备,是制程步骤最多、工艺过程开发难度最高的设备。
4、干法刻蚀可分为电容性等离子体刻蚀(CCP)和电感性等离子体刻蚀(ICP)两大类。
CCP受益3D发展趋势,制程微缩推动ICP需求增长。
• CCP蚀刻原理:通过对相互平行放置的电极施加射频功率产生的高频电磁场激发产生等离子体。这种等离子体密度低,可调节性较差,但能量高。适用于蚀刻硬介电材料,如氧化物和氮氧化物,以及硬掩模。
• ICP蚀刻原理:通过电感应线圈产生的感应磁场产生等离子体,由于能量传递机制类似于两个电感线圈相互耦合形成的变压器,有时ICP又被称为变压器耦合等离子体(TCP)。这种等离子体密度高、能量低,但具有可相对独立控制等离子体密度和离子能量的优点。适用于蚀刻单晶硅、多晶硅、金属和其他硬度低或相对薄的材料,也适用于挖掘浅槽。
5、根据被刻蚀材料的不同,干法刻蚀可分为介质刻蚀、硅刻蚀和金属刻蚀三大类。介嶚质刻蚀和硅刻蚀为主,金属刻蚀占比仅3%。
6、干法刻蚀常见问题
包括负载效应、微沟槽效应和充电效应等。负载效应是刻蚀中最常见的问题之一,是指在刻蚀过程中由于反应等离子体不足而引起的刻蚀速率降低或刻蚀不均匀的效应。
四、3D NAND刻蚀工艺
1、3D NAND制作简要流程一览

2、3D NAND刻蚀工艺及其难点
不同于2D NAND,3D NAND的制造工艺难点从光刻技术转向沉积和刻蚀技术。
台阶刻蚀难点在于台阶尺寸的可重复性以及高选择比的侧向修整工艺(Trim)。狭缝刻蚀、沟道孔洞刻蚀和接触孔刻蚀均要求设备具有高深宽比(High Aspect Ratio,HAR)刻蚀能力。
刻蚀的难度受孔间距和模具总高度两方面决定,前者与横向缩放即制程有关,后者与堆叠层数有关。三星表示刻蚀难度与模具高度平方成正比,与通道口间距立方成反比。Lam Research数据显示,96层3D NAND晶圆的刻蚀深宽比高达70:1,且每块晶圆中约有一万亿个细小通孔,这些孔道必须互相平行规整。
3、CMOS结构涉及刻蚀工艺
CMOS结构涉及的刻蚀工艺主要为浅层沟道隔离刻蚀、栅极刻蚀、补偿侧墙刻蚀、钨接触孔刻蚀、铜通孔(Via)刻蚀和介质沟槽(Trench)刻蚀。
浅层沟道隔离刻蚀、栅极刻蚀和钨接触孔刻蚀三类工艺对均匀性要求高,因此静电吸盘需要具备多动态控温功能,同时设备还需配置多区气体分配系统。
五、DRAM刻蚀工艺
DRAM刻蚀工艺按刻蚀材料可分为导体刻蚀和介质刻蚀BEOL的MCNia/Trench/PAD、MEOL的CC/PC和Cell的Cap及其介质掩膜版(Mask Open)均属于介质刻蚀工艺,常采用电容耦合等离子体(CCP)刻蚀设备。
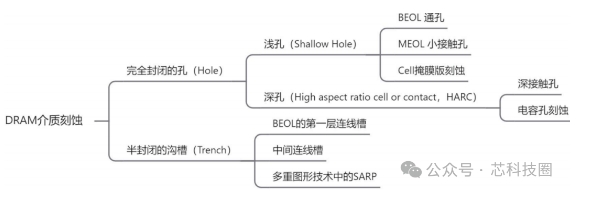
六、设备与市场:全球竞争的“硬核战场”
刻蚀机是工艺核心设备,需满足高选择性(只刻目标材料)、高均匀性(整片硅片效果一致)、高保真度(图案与设计图吻合)三大要求。
全球市场呈现“三足鼎立”格局:应用材料(美国)、东京电子(日本)、泛林半导体(美国)占据超90%份额,技术壁垒极高。
北方华创布局刻蚀/薄膜沉积/清洗/热处理四大应用领域,打造半导体设备平台型企业。现已形成对刻蚀工艺的全覆盖,2023年公司刻蚀设备收入近60亿元。TSV刻蚀设备已广泛应用于国内主流Fab 厂和先进封装厂,是国内TSV量产线的主力机台,市占率领先。
中微公司从事高端半导体设备及泛半导体设备的研发、生产和销售,布局刻蚀设备、MOCVD设备、薄膜沉积设备及其他设备四大系列产品。公司刻蚀设备分为CCP和ICP两大类,可涵盖国内近95%的刻蚀应用需求。
五、关键参数:决定精度的“三大标尺”
刻蚀工艺参数包括不完全刻蚀、过刻蚀、刻蚀速率、钻蚀、选择比、均匀性、线宽粗糙度、纵横比及侧边的各向异性/各向同性刻蚀等。
其中决定精度的三大标尺:
1.刻蚀速率:单位时间去除材料厚度,需在效率与精度间平衡;
2.刻蚀选择比:目标材料与其他材料的刻蚀速率比,比值越高越精准;
3.线宽粗糙度:图案边缘光滑度,粗糙度越低,芯片性能越稳定。
上一篇:开关电源的常见术语
在线留言询价
- 一周热料
- 紧缺物料秒杀
| 型号 | 品牌 | 询价 |
|---|---|---|
| BD71847AMWV-E2 | ROHM Semiconductor | |
| CDZVT2R20B | ROHM Semiconductor | |
| MC33074DR2G | onsemi | |
| TL431ACLPR | Texas Instruments | |
| RB751G-40T2R | ROHM Semiconductor |
| 型号 | 品牌 | 抢购 |
|---|---|---|
| TPS63050YFFR | Texas Instruments | |
| BU33JA2MNVX-CTL | ROHM Semiconductor | |
| IPZ40N04S5L4R8ATMA1 | Infineon Technologies | |
| ESR03EZPJ151 | ROHM Semiconductor | |
| STM32F429IGT6 | STMicroelectronics | |
| BP3621 | ROHM Semiconductor |
AMEYA360公众号二维码
识别二维码,即可关注


请输入下方图片中的验证码:






















